微波等离子去胶机
微波等离子去胶机去胶机应用
微波等离子去胶机
简介:
去胶工艺是微加工工艺过程中一个非常重要的工艺环节。在光刻工艺之后,我们往往需要面临显影后的底胶去除或者干法蚀刻工艺后变性的光刻胶的去除工作,这些环节中光刻胶去除的是否干净以及对样片是否有损伤等将直接影响到后续工艺的进行以及器件的性能。德国ALPHA PLAMSA拥有多年的微波等离子去胶机设计制造历史以及丰富去胶经验,致力于为您提供专业的微波等离子去胶机系统,并提供专业的技术支持服务。
产品优势:
- 去胶快速干净
- 对样片无损伤
- 操作简单安全
- 设计紧凑美观
- 产品性价比高
应用领域:
- 高剂量离子注入光刻胶的去除
- 湿法或干法刻蚀前后残胶去除
- MEMS中牺牲层的去除
- 去除化学残余物
- 去浮渣工艺
- SU-8光刻胶去除
产品列表

微波等离子去胶机 Q 150
| 工艺腔室:石英 |
| 腔室容量:6升 |
| 腔室尺寸:φ150 ×260mm |
| 样品尺寸:4寸,向下兼容 |
| 腔门:抽屉式,带观察窗 |
| 微 波 源:2.45GHz,50-600W可调 |
| 气 路:标配两路工艺气体,带质量流量计 |
| 真 空 规:pirani,1-1×105Pa |
| 真 空 泵:干泵, XDS35i BOC Edwards |
| 真 空 阀:电子气动阀 |
| 控制系统:7寸触摸屏,Windows系统,图形化操作界面 |
| 选 配 件:气路(可升级至4路),选配法拉第笼 |
| 电力需求:3/N/PE AC 50Hz 400/240V 16A |
| 整机尺寸:500(W)× 550(D)× 370(H)mm |
微波等离子去胶机 Q 235
| 工艺腔室:石英 |
| 腔室容量:11升 |
| 腔室尺寸:φ240 ×260mm |
| 样品尺寸:6寸,向下兼容(最大可支持8寸) |
| 腔门:抽屉式,带观察窗 |
| 微 波 源:2.45GHz,50-600W可调 |
| 气 路:标配两路工艺气体,带质量流量计 |
| 真 空 规:pirani,1-1×105Pa |
| 真 空 泵:干泵, XDS35i BOC Edwards |
| 真 空 阀:电子气动阀 |
| 控制系统:10.4寸触摸屏,Windows系统,图形化操作界面 |
| 选 配 件:气路(可升级至4路),选配高温、温控盘或法拉第笼 |
| 电力需求:3/N/PE AC 50Hz 400/240V 16A |
| 整机尺寸:620(W)× 550(D)× 500(H)mm |


微波等离子去胶机 Q 240
| 工艺腔室:石英 |
| 腔室容量:21升 |
| 腔室尺寸:φ240 ×460mm |
| 样品尺寸:6寸,向下兼容,最大可处理8寸样品 |
| 腔门:抽屉式,带观察窗 |
| 微 波 源:2.45GHz,50-1200W可调 |
| 气 路:标配三路工艺气体,带质量流量计 |
| 真 空 规:Baratron,1-1,000Pa |
| 真 空 泵:干泵, XDS35i BOC Edwards |
| 真 空 阀:电子气动阀 |
| 控制系统:10.4寸触摸屏,Windows系统,图形化操作界面 |
| 选 配 件:气路(可升级至4路),选配高温、温控盘或法拉第笼电 |
| 电力需求:3/N/PE AC 50Hz 400/240V 16A |
| 整机尺寸:760(W)× 775(D)× 775(H)mm |
微波等离子去胶机 ASTRO PACT-10H
| 工艺腔室:铝 |
| 腔室容量:10升 |
| 腔室尺寸:250(W)× 250(D)× 170(H)mm |
| 样品尺寸:6寸,向下兼容,最大可处理8寸样品 |
| 腔门:抽屉式带加热台盘60-200℃,带观察窗 |
| 微 波 源:2.45GHz,最大1200W |
| 气 路:标配两路工艺气体,带质量流量计 |
| 真 空 规:Pirani |
| 真 空 泵:干泵或者油泵可选 |
| 真 空 阀:电子气动阀 |
| 控制系统:10.4寸触摸屏,Windows系统,图形化操作界面 |
| 选 配 件:气路(可升级至4路),选配250℃加热台盘 |
| 电力需求:3/N/PE AC 50Hz 400/240V 16A |
| 整机尺寸:450(W)× 640(D)× 725(H)mm |


微波等离子去胶机 ASTRO PACT-20H
| 工艺腔室:铝 |
| 腔室容量:20升 |
| 腔室尺寸:350(W)× 350(D)× 170(H)mm |
| 样品尺寸:12寸,向下兼容 |
| 腔门:抽屉式带加热台盘60-200℃,带观察窗 |
| 微 波 源:2.45GHz,最大1200W |
| 气 路:标配两路工艺气体,带质量流量计 |
| 真 空 规:Pirani, PCR280 Standard |
| 真 空 泵:干泵或者油泵可选 |
| 真 空 阀:电子气动阀 |
| 控制系统:10.4寸触摸屏,Windows系统,图形化操作界面 |
| 选 配 件:气路(可升级至4路),选配250℃加热台盘 |
| 电力需求:3/N/PE AC 50Hz 400/240V 16A |
| 整机尺寸:560(W)× 770(D)× 770(H)mm |
微波等离子去胶机 ASTRO PACT-W
| 工艺腔室:铝 |
| 腔室容量:10升 |
| 腔室尺寸:250(W)× 250(D)× 170(H)mm |
| 样品尺寸:6寸,向下兼容 |
| 腔门:抽屉式带加热台盘60-200℃,带观察窗 |
| 微 波 源:2.45GHz,最大1200W |
| 气 路:标配三路工艺气体,带质量流量计 |
| 真 空 规:Pirani |
| 真 空 泵:抽速60m3/h,干泵或者油泵可选 |
| 真 空 阀:电子气动阀 |
| 控制系统:10.4寸触摸屏,带机械手臂、中心校准、进出料盒平台 |
| 选 配 件:气路(可升级至4路),选配250℃加热台盘 |
| 电力需求:3/N/PE AC 50Hz 400/240V 16A |
| 整机尺寸:920(W)× 1200(D)× 1200(H)mm |

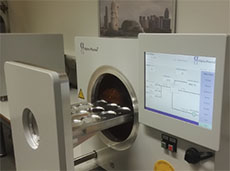
2寸样品托盘
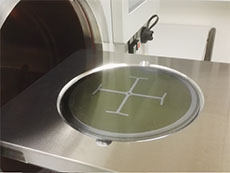
8寸样品托盘
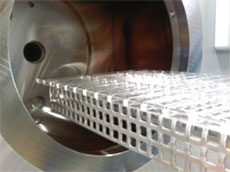
石英样品托盘

石英舟批量处理
分享到:



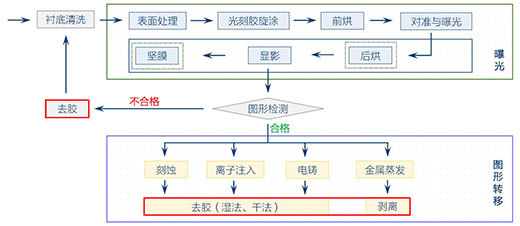

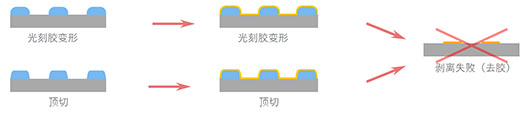
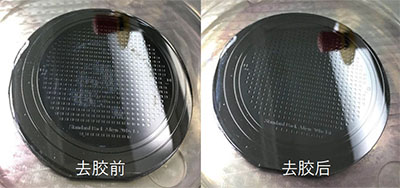

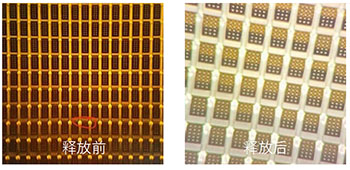
 扫码咨询光刻胶、模板
扫码咨询光刻胶、模板
 扫码咨询红外测温仪、单晶、靶材
扫码咨询红外测温仪、单晶、靶材
 扫码咨询介电阻抗谱、杨氏模量无损测量
扫码咨询介电阻抗谱、杨氏模量无损测量